成膜装置
装置名:RFスパッタ装置
- 製品名:RFS-200
- メーカー:ULVAC
<装置の概要>
- RF電源を搭載した高周波スパッタ
リング装置です。 - 金属、半導体、絶縁物の成膜が
可能です。 - φ80mmカソード一基で、単層成膜
となります。
<装置の仕様>
| 有効成膜範囲 | 50mm |
|---|---|
| 膜厚分布 | ±8%以内 (SiO2成膜時) |
| 基板加熱温度 | Max.350℃ |
| 基板/電極間距離 | 30~60mm |
| 排気系 | 油拡散ポンプ、RP |
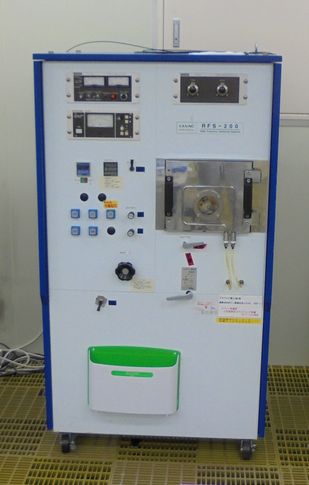
装置名:電子ビーム装置
- 製品名:VPC-1100
- メーカー:ULVAC
<装置の概要>
- 電子ビーム式の蒸着装置です。
- 高融点金属等の成膜が可能です。
<装置の仕様>
| 基板サイズ | □50mm |
|---|---|
| 真空槽 | ガラスベルジャー |
| 排気系 | 油拡散ポンプ、RP |
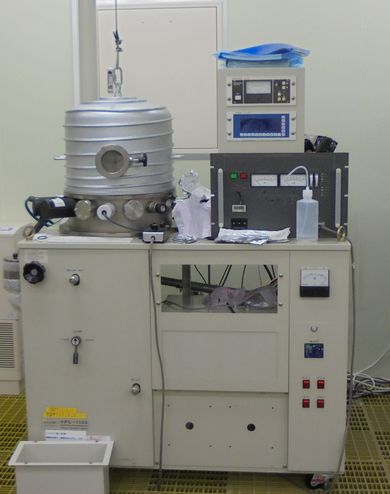
装置名:実験用蒸着装置
- 製品名:EA-504
- メーカー:昭和真空
<装置の概要>
- 抵抗加熱の蒸着装置です。
- アルミ、金などを蒸着できます。
<装置の仕様>
| 基板サイズ | 8インチまで |
|---|---|
| 操作系 | 手動制御 |
| 排気系 | 油拡散ポンプ、 RP |

装置名:TEOS-CVD装置
- 製品名:PD-220N
- メーカー:SAMCO
<装置の概要>
- TEOS-SiO2膜のCVD装置です。
- 8インチウエハまで成膜できます。
- 最大100ステッププロセス可能。
<装置の仕様>
| 基板サイズ | 8インチまで |
|---|---|
| 操作系 | タッチパネル プログラム制御 |
| 排気系 | ターボ分子ポンプ、 DRP |

装置名:卓上スパッタ装置
- 製品名:nanoPVD-S10A
- メーカー:MOORFIELD NANOTECHNOLOGY
<装置の概要>
- 3元スパッタ装置です。
- アルミ、酸化物などを成膜できます。
<装置の仕様>
| 基板サイズ | 4インチまで |
|---|---|
| 操作系 | タッチパネル プログラム制御 |
| 排気系 | RPポンプ、TMPポンプ RP |




